-
封测:国内4大集成电路封测企业介绍,专业化分工是未来发展方向
老范说评 / 2022-03-17 10:06 发布
1. 封测位于集成电路产业链下游,专业化分工是未来发展方向
1.1 封测位于集成电路产业链下游,发展可分为五个阶段
集成电路是半导体制造业的核心,占半导体行业规模八成以上。
从产业链角度划分,半导体产业链可分为上游半导体设备及材料产业、中游半导体制造产业和下游应用产业,其中中游的半导体制造产业按照产品分类可分为光学光电子、传感器、分立器件和集成电路四大类,而集成电路又可分为逻辑芯片、存储芯片、模拟电路和微处理器四类。
从市场规模占比来看,集成电路是半导体制造业的核心,占半导体行业规模的八成以上。

从制造工艺角度看,集成电路产业链从上至下可分为设计、制造和封测三大环节,其中集成电路封测是集成电路产品制造的后道工序。
绝大部分芯片设计公司采用 Fabless 模式,本身无晶圆制造环节和封装厂测试环节,其完成芯片设计后,将版图交给晶圆代工厂制造晶圆,晶圆完工后交给下游封测企业,封测企业根据客户要求的封装类型和技术参数,将芯片裸晶加工成可直接装配在 PCB 电路板上的集成电路元器件。
封装完成后,根据客户要求,对芯片产品的电压、电流、时间、温度、电阻、电容、频率、脉宽、占空比等参数进行专业测试。
完成晶圆芯片的封装加工和测试后,封测企业将芯片成品交付给客户,获得收入和利润。

封测包含封装和测试两个环节。
集成电路封测是集成电路产品制造的后道工序,指将通过测试的晶圆按产品型号及功能需求加工得到独立集成电路的过程,可分为封装与测试两个环节。
从价值占比看,根据 Gartner 数据,集成电路封装环节价值占比约为 80%-85%,测试环节价值占比约为 15%-20%。
集成电路封装:将通过测试的晶圆加工得到独立芯片的过程,使电路芯片免受周围环境的影响(包括物理、化学的影响),起着保护芯片、增强导热(散热)性能、实现电气和物理连接、功率分配、信号分配,以沟通芯片内部与外部电路的作用,它是集成电路和系统级板如印制板(PCB)互连实现电子产品功能的桥梁。通常认为,集成电路封装主要有电气特性的保持、芯片保护、应力缓和及尺寸调整配合四大功能。

集成电路发展的五个阶段。
根据《中国半导体封装业的发展》,迄今为止全球集成电路封测行业可分为五个发展阶段,自第三阶段起的封装技术统称为先进封装技术。
当前,中国封装企业大多以第一、第二阶段的传统封装技术为主,例如 DiP、SOP 等,产品定位中低端;全球封装业的主流技术术处于以 CSP、BGA 为主的第三阶段,并向以系统级封装(SiP)、倒装焊封装(FC)、芯片上制作凸点(Bumping)为代表的第四阶段和第五阶段封装技术迈进。
先进封装技术更迎合集成电路微小化、复杂化和集成化的发展趋势,是封测产业未来的发展方向。
国内集成电路测试企业可分为三个梯队。
按照技术储备、产品线、先进封装收入占比等指标,可将国内集成电路企业大致分为三个梯队:
第一梯队已实现了 BGA、LGA 和 CSP 稳定量产,具备部分或全部第四阶段封装技术量产能力,同时在第五阶段晶圆级封装领域进行技术储备或产业布局,国内企业以长电科技、通富微电和华天科技为代表;
第二梯队企业产品以第一、二阶段为主,并具备第三阶段技术储备,这类企业大多为国内区 域性封测领先企业;
第三梯队企业产品主要为第一阶段通孔插装型封装,少量生产第二阶段表面贴装型封装产品,这类企业以众多小规模封测企业为主。

1.2 传统 IDM 模式压力日益明显,专业化分工是集成电路未来发展方向
全球集成电路企业生产模式:可分为 IDM 模式和 Foundry 模式。
集成电路的制造企业的经营模式主要包括两种:
一种是 IDM 模式,即垂直整合制造模式,代表性公司包括英特尔、索尼、海力士和美光等,其业务涵盖了集成电路设计、制造和封测的每一环节;
另一种是 Foundry 模式,即晶圆代工模式,仅专注于集成电路制造环节,并将集成电路封 装、测试委托给下游专业封测厂商进行代工,代表性企业包括台积电、中芯国际等。
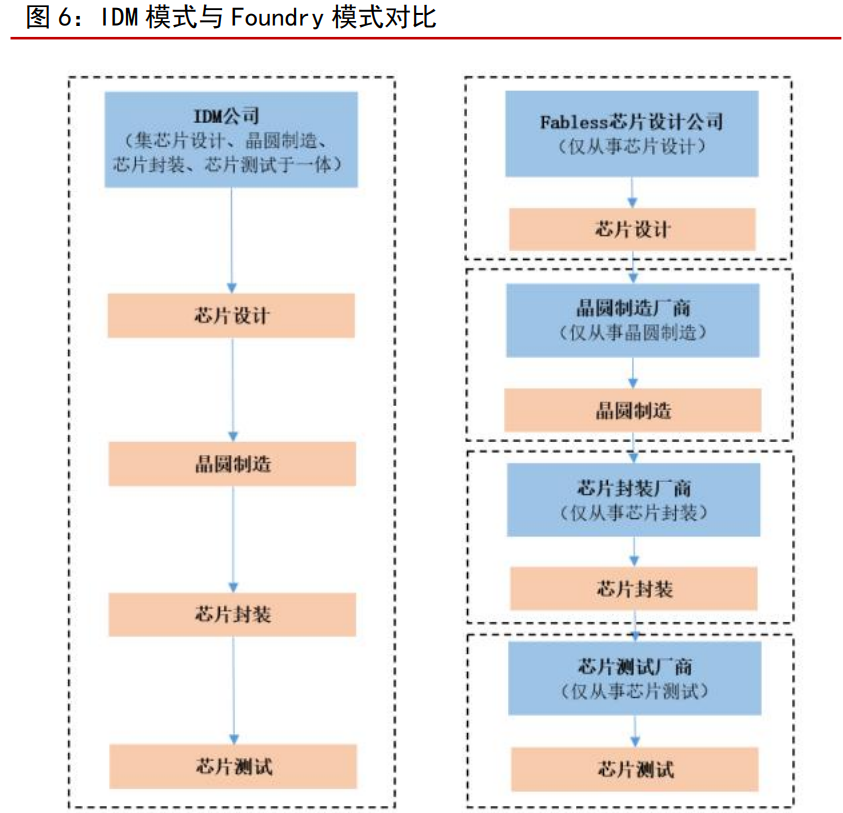
传统 IDM 模式压力日益加大,集成电路专业化分工成为发展方向。
一般来说,垂直整合制造(IDM)模式下的集成电路企业不仅包括集成电路设计部门、晶圆制造厂,还包括下游的封装测试厂,属于重资产经营模式,对企业的研发能力、资金实力和技术水平都具有较高要求,在晶圆制程和封装技术方面难以保持先进性;而 Foundry 模式则源于产业链的专业化分工,从上游到下游形成无晶圆厂设计公司(Fabless 企业)、晶圆代工企业和封装测试企业。
与传统 IDM 模式相比,分工细化的模式使得成本更加节约,资源更加专注,有效降低了行业的投资门槛,是近年来集成电路产业最重要的模式变化。
为了应对激烈的市场竞争,大型半导体 IDM 公司逐步将封装测试环节剥离交由专业的封测公司处理,封测行业变成集成电路行业中一个独立子行业。
在集成电路行业专业化、分工化的发展趋势下,将有更多的晶圆制造和集成电路封测订单从传统 IDM 厂商流出,对下游封测企业构成利好。
随着上游高附加值的芯片设计行业加快发展,也更有利于推进处于产业链下游的集成电路测试行业的发展。

全球晶圆制造企业集中度较高,行业前十占比合计达 97%。
从全球前十大半导体晶圆制造企业情况来看,由于晶圆制造行业具有较高的技术与资金壁垒,因此行业集中度极高,全球前十大晶圆制造企业合计营收在全球晶圆制造市场规模超过 95%。
根据 TrendForce 数据,2021 年前三季度全球前十大晶圆制造企业中,仅有三星采用 IDM 模式,拥有自身的封测产线,台积电也开始将自身业务向下游封测企业渗透,其他晶圆代工企业自身均不具备封测产线,需要与下游封测企业合作,才能完成最后的封测工艺。

我国集成电路三大环节共同发展,专业化分工趋势明显。
根据中国半导体行业协会数据,2021 年上半年我国集成电路累计实现销售额 4,102.9 亿元,同比增长 15.93%。
从各产业链环节看,2021 年上半年我国集成电路设计、制造和封测环节销售额分别为 1,766.40 亿元、1,171.80 亿元和 1,164.70 亿元,占集成电路总销售额比重分别为 43.05%、28.56% 和 28.39%。
从国内集成电路结构来看,我国集成电路设计、制造和封测三个环节齐头并进发展,专业化分工趋势明显。

集成电路封装材料门槛相对较低,我国已基本实现国产替代。
封测行业上游不仅包含晶圆制造企业,还包含半导体封装材料供应商。半导体封装材料包括芯片粘结材料、封装基板、引线框架、陶瓷基板、键合线及包装材料等,其中封装基板市场规模最大。
根据头豹研究院数据,2018 年国内芯片粘结材料、封装基板、引线框架、陶瓷基板、键合线及包封材料市场规模占比分别为 3.9%、38.2%、15.8%、11.3%、13.9%和15.0%。与晶圆制造材料相比,集成电路封装材料的门槛相对较低,我国已基本实现国产替代。

2.全球封测市场规模稳健成长,先进封装成未来增长动力
2.1 我国集成电路市场规模增速快于行业平均,晶圆厂建厂潮拉动下游封测需求
半导体下游应用广泛,市场规模稳定发展。半导体下游应用广泛,涵盖消费电子、电力电子、交通、医疗、通讯技术、医疗、航空航天等众多领域。
近年来,随着物联网、人工智能、云计算、大数据、5G、机器人等新兴应用领域的蓬勃发展,各类半导体产品的使用场景和用量不断增长,为半导体产业注入了新的增长动力。
根据美国半导体产业协会的数据,全球半导体销售额从 2011 年的 3,003.4 亿美元增长至 2021 年的 5,475.8 亿美元,2011-2021 年 CAGR 为 4.46%,市场规模稳步增长;而中国半导体销售额从 2016 年的 1,091.6 亿元增长至 2021 年的 1,903.9 亿元,2016-2021 年 CAGR 为 11.78%,增速高于全球平均水平,销售额占全球比重从 2016 年的 30.83%提升至 2021 年的 34.77%。

集成电路历史上经历了两次空间上的产业转移,目前正进行第三次产业转移。
第一次为 20 世纪 70 年代从美国向日本转移,第二次是 20 世纪 80 年代从日本向韩国和中国台湾地区转移。
目前,全球集成电路行业正在开始第三次产业转移,即向中国大陆转移。中国凭借其巨大的消费电子市场、庞大的电子制造业基础以及劳动力成本优势,吸引了全球集成电路公司在国内投资。
历史上已经成功完成的两次产业转移都带动了转入国集成电路产业的发展,从芯片设计、晶圆制造、芯片封装、集成电路测试,每一个产业分工环节都会有巨大的进步,最终实现全产业链的整体发展。
目前我国国内集成电路产业已经出具规模,初步奠定了由芯片设计、晶圆制造、芯片封装和集成电路测试四个主要环节及支撑配套产业构成的产业链格局。
因此,随着第三次产业转移的不断深入,受益于集成电路产业加速向中国大陆转移,集成电路进口替代也将加快步伐。

国内集成电路国产替代速度加快。
根据国家统计局的数据,我国集成电路总生产量从 2011 年的 761.80 亿块增长至 2021 年的 3,594.30 亿块,2011-2021 年的复合增长率为 16.78%。
作为对照,国内集成电路进口金额从 2011 年的 1,701.99 亿美元增长至 2021 年 的 4,325.54 亿美元,2011-2022 年的复合增长率为 4.42%。
由此可见,近十年我国集成电路生产速度快于集成电路进口增长速度,表明我国集成电路行业国产替代速度加快,集成电路生产量不断提高,已部分实现国产替代。

国产替代趋势持续,我国集成电路封测产值占比不断提高。
在半导体产业转移、人力资源成本优势、税收优惠等因素促进下,全球集成电路封测厂逐渐向亚太地区转移,目前亚太地区占全球集成电路封测市场 80%以上的份额。
根据市场调研机构 Yole 统计数据,全球集成电路封测市场长期保持平稳增长,从 2011 年的 455 亿美元增至 2019 年的 564 亿美元,年均复合增长率为 2.72%。同全球集成电路封测行业相比,我国封测行业增速较快。
根据中国半导体行业协会统计数据,2009 年至 2019 年,我国封测行业年均复合增长率为 16.78%,占全球封测市场份额比例也在不断提升。

集成电路封测为我国集成电路领域最具竞争力环节,共有三家企业营收位列全球前十。
在集成电路设计和制造环节,我国和世界顶尖水平差距较大,特别是在制造领域最为薄弱,而封测环节则为我国集成电路三大领域最为强势的环节。
近年来,国内封测龙头企业通过自主研发和并购重组,在先进封装领域正逐渐缩小同国际先进企业的技术差距。
我国封测企业在集成电路国际市场分工中已有了较强的市场竞争力,有能力参与国际市场竞争。
根据 ittbank 数据,2021年全球营收前十大封测厂商排名中,有三家企业位于中国大陆,分别为长电科技、通富微电和华天科技。
表 6:2021 年全球前十大封装测试企业

大陆晶圆厂建厂潮产能释放,新增大量集成电路封测需求。
根据甬矽电子招股说明书,目前中国大陆已成为全球最大的集成电路终端产品消费市场和制造基地,受益集成电路产业加速向大陆转移的趋势,全球晶圆制造产能也不断向中国大陆转移,诸如台积电、中芯国际、长江存储等企业在中国大陆大力投资建厂。
根据 SEMI 数据,美国集成电路制造业产能已从 1980 年的 42%,跌至 2020 年的 12.8%, 而我国大陆地区晶圆产能已从 2011 年的 9%,提升至 2020 年的 18%。
根据 SEMI 预测,2018-2025 年中国大陆地区的晶圆产能占全球的比例将从 18%提高至 22%,年复合增长率约为 7%。
随着全球集成电路制造业逐渐向大陆地区转移,集成电路封测业作为晶圆制造产业链的下游环节,将充分受益于全球晶圆产能转移带来的封测市场需求传导。

AIoT 时代智能连接数量井喷,有效拉动下游封测需求。
互联网时代主要解决人与人之间的连接互联,人们可通过互联网进行交互。而物联网主要提供物与物的连接方式,物与物的交互为消费产业和工业产业都带来了新的增长机遇,终端连接数量实现井喷式增长。
根据 IoT Analytics 数据,2019 年全球物联网连接数与非物联网连接数持平,2020 年首次 超过非物联网连接数,而疫情加速了个人、家庭和企业拥抱 AIoT 的进程,行业进入快速发展阶段。
根据 IoT Analytics 预测,2020-2025 年全球 IoT 连接数将从 117.0 亿只增加至 309.0 亿只,复合增速为 21.4%。
物联网终端连接数量快速增长,有效拉动了集成电路的封测需求,国内集成电路封测市场有望快速扩容。

IC insights:预计 2022 年全球半导体资本开支将创历史新高。
受疫情影响,全球半导体众多供应链在疫情期间供应持续紧张或中断,叠加下游新能源汽车、AioT 和 AR/VR 等的旺盛需求,众多半导体代工厂产能利用率高企。
基于疫情背景下强劲的产能利用率和持续的高需求预期,全球半导体大厂资本开支有望保持强劲。
根据市场调研机构 IC insights 报告显示,继 2021 年同比增长 36%后,预计 2022 年全球半导体行业资本开支将继续增长 24%,达到 1,904 亿美元,创历史新高。

台积电、联电月度营收连创新高,彰显晶圆代工高景气度。
全球晶圆代工厂景气高企,以台企为例,自 2020 年以来台积电、联电产能持续紧俏,特别是 8 英寸晶圆代工产能供不应求。
2021 年全年,台积电实现营收 15,874.15 亿新台币,同比增长 18.53%;2022 年 1 月实现营收 1,721.76 亿新台币,同比增长 35.84%;联电 2021年实现营收 2,130.11亿新台币,同比增长 20.47%,2022 年 1 月实现营收 204.73 亿新台币,同比增长 31.83%,产能利用率接近 100%。
全球晶圆厂产能持续满载,下游封测厂商也有望同步受益。

中芯国际:
根据公司业绩快报,中芯国际 2021 年实现营业收入 356.31 亿元,同比增长 29.71%,实现归母净利润 107.33 亿元,同比增长 147.70%,其中扣非后归母净利润为 52.11 亿元,同比增长 207.07%。
公司于 3 月 8 日公布 2022 年前两季度经营数据,公司 2022 年 1 至 2 月实现营业收入约 12.23 亿美元,同比增长 59.1%,实现归属上市公司股东的净利润 3.09 亿美元左右,同比增长 94.9%。
综合来看,中芯国际一季度代工产能持续偏紧,涨价挑单持续;资本开支方面,公司 2021 年全年资本开支达 45 亿美元,超过此前指引的 43 亿美元。
公司预计 2022 年全年资本开始将达到 50 亿美元,主要用于京城、临港和深圳三个新厂的建设和老厂的扩容。
在持续高 CAPEX 投入之下,晶圆制造企业下游的封测厂商有望获益。

2.2 后摩尔时代,先进封装成封测行业成长驱动力
“摩尔定律”发展陷入瓶颈,集成电路进入后摩尔时代。
在集成电路制程方面,“摩尔定律”认为集成电路上可容纳的元器件的数目,约每隔 18-24 个月便会增加一倍,性能也将提升一倍。
长期以来,“摩尔定律”一直引领着集成电路制程技术的发展与进步,自 1987 年的 1um 制程至 2015 年的 14nm 制程,集成电路制程迭代一直符合“摩尔定律”的规律。
但 2015 年以后,集成电路制程的发展进入了瓶颈,7nm、5nm、3nm 制程的量产进度均落后于预期。
随着台积电宣布 2nm 制程工艺实现突破,集成电路制程工艺已接近物理尺寸的极限,行业进入了“后摩尔时代”。

后摩尔时代,先进封装成为提升芯片性能的重要途径。
“后摩尔时代”制程技术突破难度较大,工艺制程受成本大幅增长和技术壁垒等因素上升改进速度放缓。
根据市场调研机构 ICInsights 统计,28nm 制程节点的芯片开发成本为 5,130 万美元,16nm 节点的开发成本为 1 亿美元,7nm 节点的开发成本需要 2.97 亿美元,而 5nm 节点开发成本则上升至 5.4 亿美元。
由于集成电路制程工艺短期内难以突破,通过先进封装技术提升芯片整体性能成为了集成电路行业技术发展趋势。
晶圆级封装、系统级封装成为未来发展方向。
随着下游应用领域对集成电路芯片的功能、能耗及体积要求越来越高,集成电路技术发展形成了两个方向:单芯片系统(SoC, System on Chip)和系统级封装(SiP,System in Package)。其中单芯片系统(SoC)是从设计和晶圆制造角度出发,将系统所需的组件和功能集成到一枚芯片上;系统级封装(SiP)则是从封装角度出发,将不同功能的芯片和元器件组装到一个封装体内。

系统级封装(SiP)是先进封装市场的重要动力。
系统级封装(SiP)可以把多枚功能不同的晶粒(Die,如运算器、传感器、存储器)、不同功能的电子元器件(如电阻、电容、电感、滤波器、天线)甚至微机电系统、光学器件混合搭载于同一封装体内,产品灵活度大,研发成本和周期远低于复杂程度相同的单芯片系统(SoC)。
在后摩尔时代,SiP 开发成本较低、开发周期较短、集成方式灵活多变,具有更大的设计自由度。
针对有更多功能、更高频率、更低功耗需求的应用市场,包括 5G 通信用的射频前端、物联网用的传感器芯片、智能汽车用的功率芯片等,系统级封装(SiP)具有较为显著的优势,下游应用领域对先进封装的依赖程度增加,先进封装企业迎来更好的发展机遇。
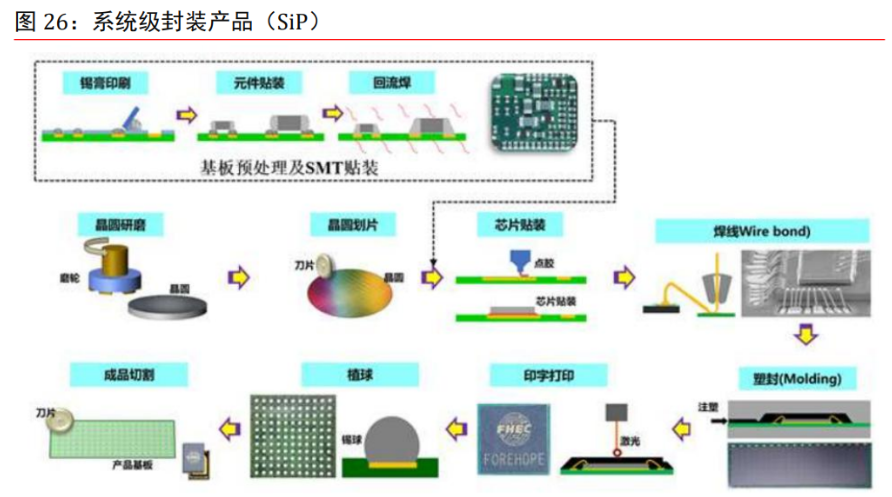
新兴应用场景快速兴起,先进封装下游应用广泛。
随着 5G 通信技术、物联网、大数据、人工智能、视觉识别、自动驾驶等应用场景的快速兴起,应用市场对芯片功能多样化的需求程度越来越高。
在芯片制程技术进入“后摩尔时代”后,先进封装技术能在不单纯依靠芯片制程工艺实现突破的情况下,通过晶圆级封装和系统级封装,提高产品集成度和功能多样化,满足终端应用对芯片轻薄、低功耗、高性能的需求,同时大幅降低芯片成本。
因此,先进封装在高端逻辑芯片、存储器、射频芯片、图像处理芯片、触控芯片等领域均得到了广泛应用。
以系统级封装为例,现阶段,以智能手机为代表的移动消费电子领域是系统级封装最大的下游应用市场,占了系统级封装下游应用的 70%。
根据 Yole 预测,未来 5 年,系统级封装增长最快的应用市场将是可穿戴设备、Wi-Fi 路由器、IoT 物联网设施以及电信基础设施。
尤其随着 5G 通讯的推广和普及,5G 基站对倒装球栅阵列(FC-BGA)系统级封装芯片的需求将大幅上升,未来 5 年基站类系统级芯片市场规模年均复合增长率预计高达 41%。

预计先进封装所占份额将持续提升。
根据市场调研机构 Yole 预测数据,全球先进封装在集成电路封测市场中所占份额将持续增加。
Yole 指出,2019 年先进封装占全球封装市场的份额约为 42.60%,2019 年至 2025 年,预计全球先进封装市场规模将以 6.6%的年均复合增长率持续增长,并在 2025 年占整个封装市场的比重接近于 50%。
与此同时,Yole 预测 2019 年至 2025 全球传统封装年均复合增长率仅为 1.9%,增速远低于先进封装。

系统级封装(SiP)方面,根据 Yole 数据,2019 年全球系统级封装的市场规模约为 134 亿美元,占全球封测市场份额为 23.76%,预计到 2025 年全球系统级封装市场规模将达到 188 亿美元,2019-2025 年复合增长率为 5.81%。
图 29:2019 年系统级封装细分市场规模及占比(亿美元)
图 30: 2025 年系统级封装细分市场规模及占比(预测值,亿美元)

我国先进封装产值占全球比重稳步提升,未来有望继续提高。
与集成电路其他环节相比,我国集成电路封测业起步较早且发展较快,但仍以传统封装产品为主,先进封装产值占比较低。
近年来,国内厂商通过兼并收购,快速积累先进封装技术,目前封测厂商技术平台基本做到与海外同步,大陆先进封装产值占全球比例也在逐渐提升,从 2015 年的 10.3%提升至 2020 年的 14.8%。
作为全球最大的半导体消费国,在“下游需求高景气度+集成电路高端领域国产替代加速”的双轮驱动下,我国先进封装产值占全球比重有望进一步提高。

3. 国内主要集成电路封测企业介绍
大陆集成电路企业具备较强全球竞争力,共有三家企业营收进入世界前十。
目前,国内规模较大的集成电路封测企业包括长电科技(600584)、通富微电(002156)、华天科技(002185)和晶方科技(603005)等。
3.1 长电科技(600584)公司简介。
公司成立于 1998 年,并于 2003 年在上交所主板上市,总部位于江苏省无锡市。公司是全球领先的集成电路封装测试厂商,主营业务包括集成电路的系统集成、设计仿真、技术开发、产品认证、晶圆中测、晶圆级中道封装测试、系统级封装测试、芯片成品测试并可向世界各地的半导体客户提供直运服务。
根据芯思想研究院(ChipInsights)发布的 2021 年全球封测十强榜单,长电科技 2021 年预估营收为 309.53 亿人民币,同比增长 16.96%,营收规模在全球前十大 OSAT 中排名第三,在中国大陆位列第一。
公司业绩。
2016-2020 年,公司营业收入从 19.15 亿元增长至 26.46 亿元,年复合增长率为 8.42%,归母净利润从 1.06 亿元增长至 13.04 亿元,年复合增长率为 87.28%。
公司近年来毛利率、净利率总体呈上升趋势,其中毛利率从 19Q4 的 12.85%上升至 21Q3 的 18.80%,净利率从 19Q4 的 3.78%上升至 21Q3 的 9.80%。
截至 21Q3,公司近 8 个季度的毛利率平均值为 15.95%,净利率平均值为 6.43%。

业绩预告情况。
公司于 2022 年 1 月 25 日发布 2021 年业绩预告,预计 2021 年度实现母净利润 28.00 亿元至 30.80 亿元,同比增长 114.72%到 136.20%。
报告期内,公司持续聚焦高附加值、快速成长的市场热点应用领域,整合提升全球资源效率, 强化集团下各公司间的协同效应、技术能力和产能布局等举措,以更加匹配市场和客户需求,打造业绩长期稳定增长的长效机制,使公司各项运营积极向好。
同时,来自于国际和国内客户的订单需求强劲,各工厂持续加大成本管控与营运费用管控,调整产品结构,全面推动盈利能力提升。
此外,公司在报告期向独立第三方出售全资子公司长电国际(香港)贸易投资有限公司持有的 SJ SEMICONDUCTOR CORPORATION 全部股权,影响当期投资损益 2.86 亿元。
3.2 华天科技(002185)公司简介。
公司成立于 1998 年,并于 2007 年在深交所上市,总部位于甘肃天水。
公司 主营业务为集成电路封装测试,目前集成电路封装产品主要包括 DIP/SDIP、SOT、SOP、 SSOP、TSSOP/ETSSOP、QFP/LQFP/TQFP、QFN/DFN、BGA/LGA、FC、MCM(MCP)、SiP、 WLP、TSV、Bumping、MEMS、Fan-Out 等多个系列。
产品主要应用于计算机,网络通讯,消费电子及智能移动终端,物联网,工业自动化控制,汽车电子等电子整机和智能化领域。
根据芯思想研究院(ChipInsights)发布的 2021 年全球封测十强榜单,华天科技 2021 年预估营收为 119.67 亿人民币,同比增长 42.77%,营收规模在全球前十大 OSAT 中位列第六,在中国大陆位列第三。
公司业绩。
2016-2020 年,公司营业收入从 5.48 亿元增长至 8.38 亿元,年复合增长率为 11.20%,归母净利润从 3.91 亿元增长至 7.02 亿元,年复合增长率为 15.76%。
公司近年来毛利率、净利率稳中有升,其中毛利率从 19Q4 的 22.19%上升至 21Q3 的 25.59%,净利率从 19Q4 的 5.14%上升至 21Q3 的 14.45%。
截至 21Q3,公司近 8 个季度的毛利率平均值为 23.12%,净利率平均值为 10.74%。


业绩快报情况。
公司于 2021 年 3 月 10 日发布业绩快报,预计 2021 年实现营业收入 121.05 亿元,同比增长 44.42%,实现归母净利润 13.99 亿元,同比增长 99.36%。
报告期内,受集成电路国产替代、5G 建设加速、消费电子及汽车电子需求增长等因素影响,集成电路市场需求旺盛,公司封测订单饱满,业务规模持续扩大。
3.3 通富微电(002156)公司简介。
公司成立于 1994 年,并于 2007 年在深交所上市,总部位于江苏南通。公司主营业务为集成电路封装与测试,持续在高性能计算、5G 通讯产品、存储器和显示驱动等领域布局,并于 AMD、联发科、卓胜微、长鑫存储等国内外细分领域头部客户保持紧密合作,在 SoC、MCU、电源管理、功率器件和天线通讯产品等高成长领域持续深耕。
以 AMD 为例,公司与 AMD 形成“合资+合作”的模式,2020 年超过 50%收入来自 AMD。根据芯思想研究院(ChipInsights)发布的 2021 年全球封测十强榜单,通富微电 2021 年预估营收为 145.37 亿人民币,同比增长 34.99%,营收规模在全球前十大 OSAT 中位列第五,在中国大陆位列第二。
公司业绩。
2016-2020 年,公司营业收入从 4.59 亿元增长至 10.77 亿元,年复合增长率为 23.77%,归母净利润从 1.81 亿元增长至 3.38 亿元,年复合增长率为 16.90%。公司近年来毛利率、净利率稳中有升,其中毛利率从 19Q4 的 15.74%上升至 21Q3 的 20.03%,净利率从 19Q4 的 2.38%上升至 21Q3 的 7.40%。截至 21Q3,公司近 8 个季度的毛利率平均值为 16.66%,净利率平均值为 4.40%。
图 38:通富微电 2016-2020 年营收及同比增长率
图 39: 通富微电 2016-2020 年归母净利润及同比增长

业绩快报情况。
公司于 3 月 10 日发布 2021 年业绩快报。公司 2021 年实现营业收入 158.12 亿元,同比增长 46.84%,实现归母净利润 9.54 亿元,同比增长 181.77%。
2021 年度,受全球智能化加速发展、电子产品需求增长等因素影响,公司国际和国内客户的市场需求保持旺盛态势;公司面向未来高附加值产品以及市场热点方向,在高性能计算、存储器、汽车电子、显示驱动、5G 等应用领域,积极布局 Chiplet、2.5D/3D、扇出型、圆片级、倒装焊等封装技术与产能,形成了差异化竞争优势,部分项目及产品在 2021 年越过盈亏平衡点,开始进入收获期,核心业务持续增长;
同时,公司继续加快技术创新步伐,全力开展募投项目建设工作。
3.4 晶方科技(603005)公司简介。
公司成立于 2005 年,并于 2014 年在上交所主板上市,总部位于江苏苏州。
公司主营业务为传感器领域的封装测试服务,主要产品为芯片封装、芯片测试、芯片设计等。
公司是中国大陆首家、全球第二大能为影像传感芯片提供 WLCSP 量产服务的专业封测服务商。
根据公司 2021 年中报,公司同时具备 8 英寸、12 英寸晶圆级芯片尺寸封装技术规模量产封装线,涵盖晶圆级到芯片级的一站式综合封装服务能力,为全球晶圆级芯片尺寸封装服务的主要提供者与技术引领者。
封装产品主要包括影像传感器芯片、生物身份识别芯片等,该等产品广泛应用在手机、安防监控、身份识别、汽车电子、3D 传感等电子领域。
公司业绩。
2016-2020 年,公司营业收入从 0.51 亿元增长至 1.10 亿元,年复合增长率为 21.19%,归母净利润从 0.53 亿元增长至 3.82 亿元,年复合增长率为 63.85%。
公司近年来毛利率、净利率稳中有升,且维持在较高水平,其中毛利率从 19Q4 的 41.70%上升至 21Q3 的 52.86%,净利率从 19Q4 的 25.74%上升至 21Q3 的 38.20%。
截至 21Q3,公司近 8 个季度的毛利率平均值为 49.80%,净利率平均值为 34.90%。

业绩预告情况。
公司于 2021 年 1 月 14 日发布 2021 年度业绩预增公告,预计 2021 年度实现归母净利润 5.52 亿元至 5.75 亿元,同比增长 44.65%至 50.67%。业绩预增主要原因为:公司封装订单快速增长,产能与生产规模显著提升。
封装工艺持续拓展创新,汽车电子等新应用领域量产规模不断提升,中高像素产品逐步实现量产、Fan-out 技术在大尺寸高像素领域的量产规模持续扩大、晶圆级微型镜头业务商业化应用规模不断提升。
4. 报告总结
封测行业景气延续,先进封装作为延续摩尔定律的重要手段,已成为未来全球封测市场的主要增量。我国封测环节具备较强国产竞争力,长期看好行业高景气背景下,先进封装不断发展给行业带来的盈利能力提升。
长电科技(600584)、华天科技(002185)、通富微电(002156)和晶方科技(603005)等相关企业。

风险提示
先进封装渗透不及预期,行业景气度下滑等。
详细操作策略可以添加本人薇,搜索本作者名字的拼音即可
水晶球APP
高手云集的股票社区
X





 公安备案号 51010802001128号
公安备案号 51010802001128号